光刻是晶片製造的核心,是IC製造的最關鍵步驟,相比其他製程,對空氣的潔淨度要求最高。光刻的基本原理是利用UV光源發出的光線或電子東通過具有圖形的reticle對塗有PR膠的wafer進行曝光,PR膠見光後會發生化學變化,從而將reticle上的圖形複製到wafer上。隨著先進製程的不斷演變,高成本對產品良率和穩定性提出了更高的要求;同時,高昂的DUV、EUV scanner對進氣要求也更加嚴苛。
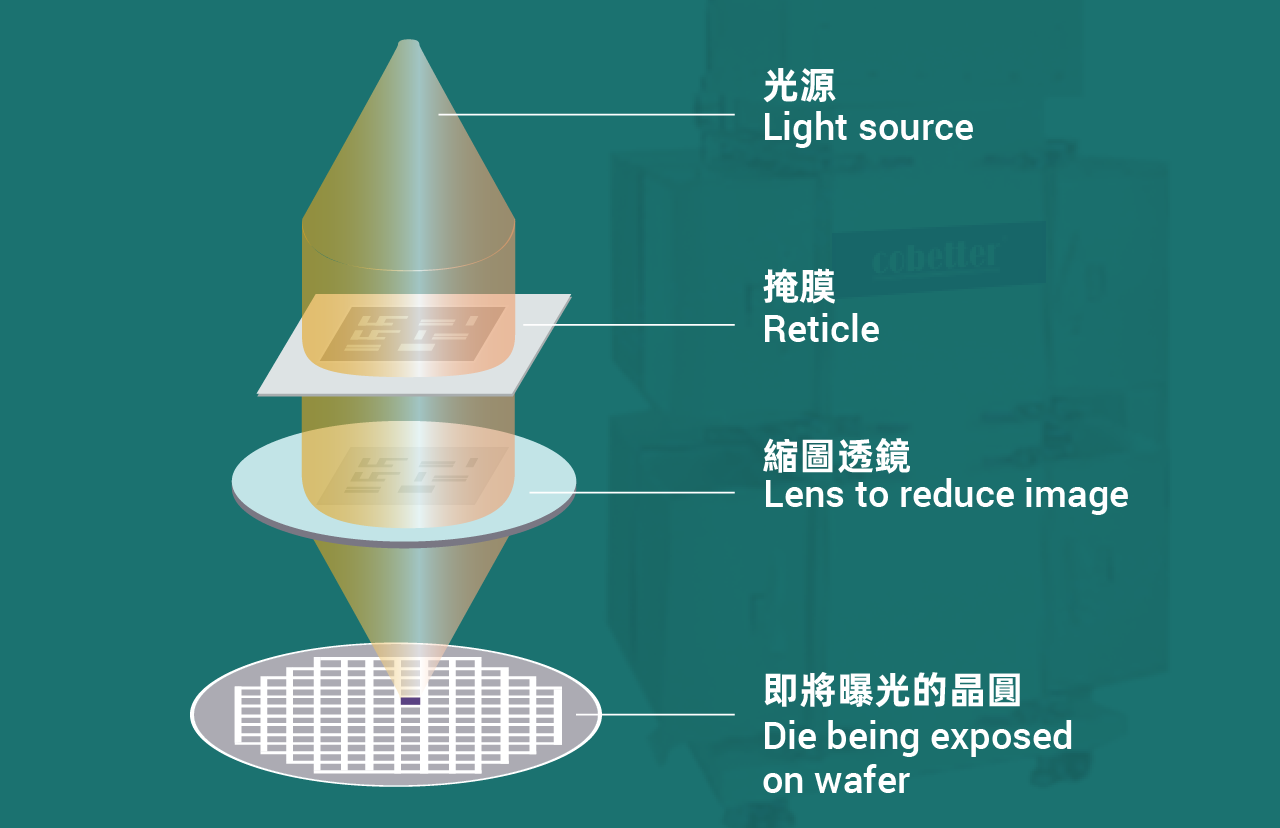
Litho區的空氣污染物主要有particle和AMC(氣態分子污染物),來源於製程chemical的散逸,PM清潔溶劑的使用,材料的釋氣等。其中,MB會導致T-top現象,MA會引起腐蝕,弱酸(乙酸)會帶來PR膠的加工問題,RC(難熔物)會影響lens的使用等。
RC難熔物的定義是除C、H、0和N外,分子裏含有其他元豐內大合物(TMS三甲基矽醇、HMDSO六甲基二矽氧烷、D3環三矽氧烷)會被193nm的紫外光分解,產生的Si與0重新結合,在光學部件的表面形成一層非晶Si02,很難去除,甚至需要更換高價的鏡頭。與深紫外(DUV)半導體工藝類似,極紫外(EUV)光刻系統對此類污染物更加敏感(13.5nm波長的極紫外光足以分裂任何分子)
以下分別是TMS,HMDSO,D3,HMDS的化學式
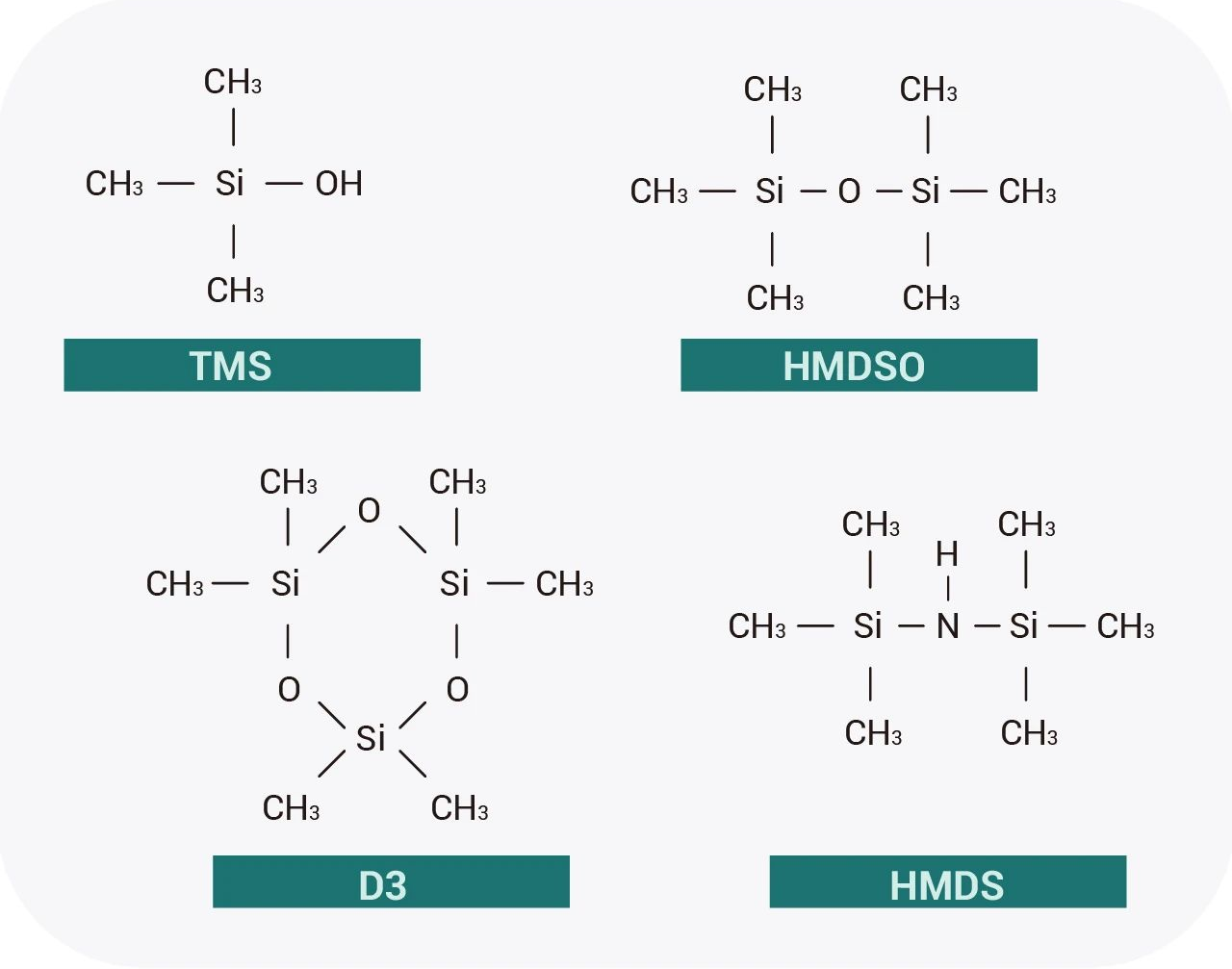
其中,TMS相對於HMDSO和D3的濃度最高。TMS最常見的來源是HMDS(六甲基二矽氮烷)在較低的相對濕度下(如RH40%)即可引起分解。當HMDSO和TMS處於平衡狀態,在水分子的影響下,會互相轉換
HMDS+ 2H20→2 TMS + NH3
HMDSO + 2H20→2 TMS
Solution
Cobetter針對此應用場景開發了全系列的過濾系統。其中,C11 prefilter濾櫃可與C12濾櫃配合使用,為scanner提供可靠全面的防護。Cobetter過濾系統可與主流機型的光刻機配套,並定制化地去除進氣中的AMC。濾櫃中搭載的AMC與ULPAfilter可滿足不同客戶的潔淨需求。C11主要針對性去除進氣中RC,同時,減少末端AMCfilter競爭吸附的影響,保證C12濾櫃filter的lifetime。與傳統AMC filter相比,C12配備了獨特設計的AMC filter,可有效地抑制PGME、TMS等副產物的產生,從而延長了產品的lifetime

Cobetter已為多家半導體用戶的scanner配套過濾系統對進入chamber的氣體進行末端過濾,達到機台要求的baseline。在此應用點位,我們實現國內廠商零的突破,打破了國外廠商的壟斷,並於2020年在國內領先的300mmFAB裏通過驗證,完成了批量更換。以下是為某12寸量產FAB的scanner提供的濾櫃解決方案,長期運行後,依然保持著很好的去除效果確保用戶scanner的進氣潔淨可靠。

作為全球領先的創新過濾企業,Cobetter專注於膜技術的開發和應用,其新開發的POU系列純化器可以去除AMC,如有機物、酸及鹼等,搭配濾櫃過濾系列,為scanner製程提供整套氣體過濾解決方案。
歡迎您的垂詢!
您可透過本網站「聯絡我們」頁面留下寶貴的資訊,或直接以電話或電子郵件與我們聯繫。我們將儘速回覆,提供您專業的解答與協助。
期待為您提供優質的服務。






